近日,上海优睿谱半导体设备有限公司(简称“优睿谱”)成功交付客户一款晶圆边缘检测设备SICE200,设备可用于硅基以及化合物半导体衬底及外延晶圆的边缘缺陷检测。
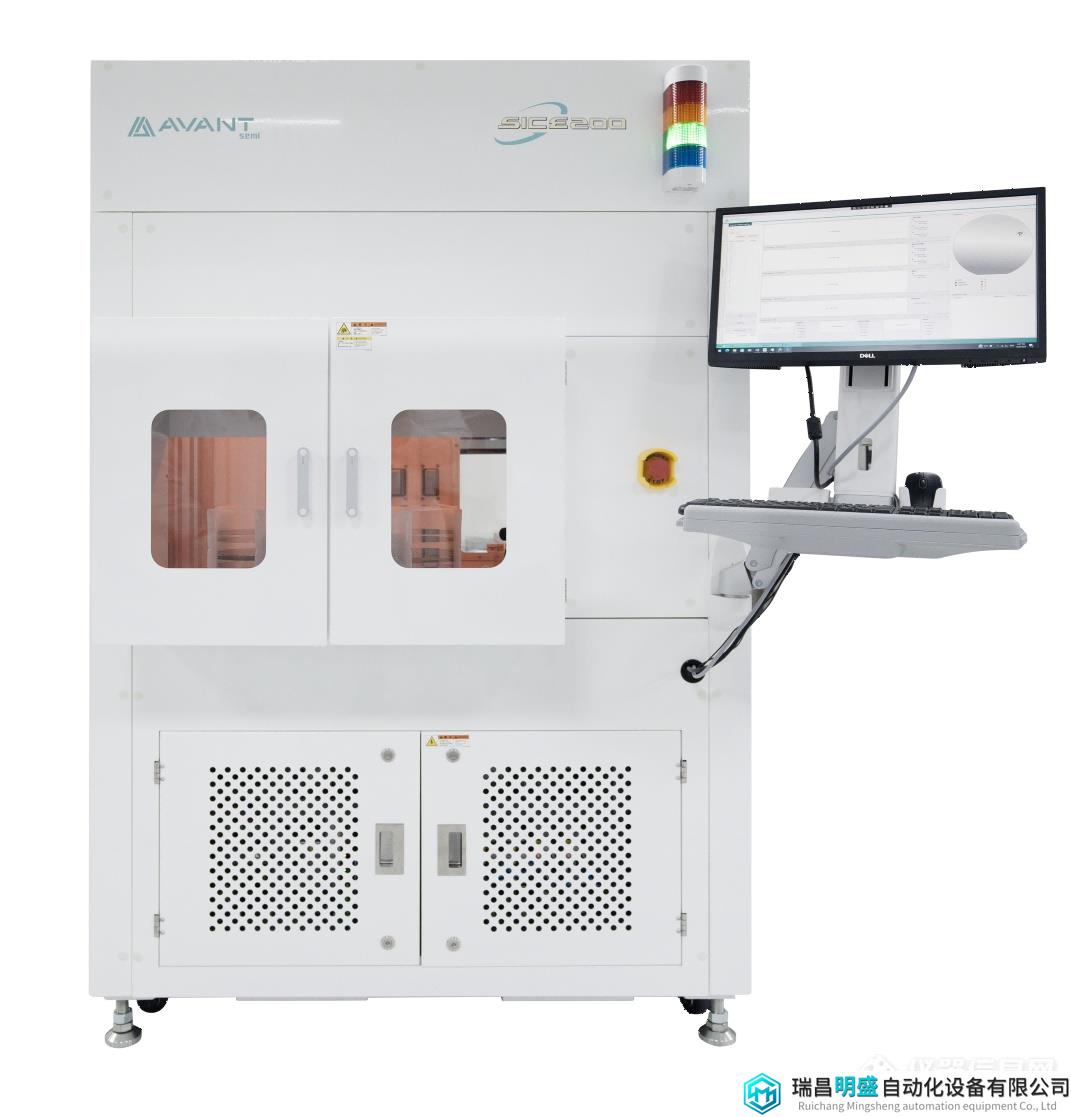
SICE200外观图片
据优睿谱总经理唐德明博士介绍,优睿谱本次推出的SICE200设备具有以下技术特点:
兼容6&8寸SiC&Si衬底和外延晶圆边缘检测,也适用于其他化合物衬底及外延晶圆的边缘缺陷检测
可同时实现对晶圆360°检测(晶圆正面、背面及边缘的缺陷检测)
可同时实现对晶圆倒角和直径精确测量(可选)
自主知识产权的光机系统可实现高分辨率、高检出率及高检测速率
晶圆厚度、TTV/Warp/Bow等参数测量(可选)
唐德明博士表示,在整机软件和缺陷检测算法层面,SICE200具备以下技术优势:
图像增强技术:凸显边缘崩边、裂纹,表面划伤,污渍等缺陷特征
丰富的条件组合判断参数化检测工具: 多种高精度的检测算法工具,具备高度的自适应能力,能够准确判断和识别缺陷类别,并准确分类
晶圆倒角和直径测量技术:对边缘轮廓、晶圆直径精确测量、拟合、计算其倒角和直径尺寸功能模块化:检测软件功能模块化,可快速配置检测程式(Recipe),满足客户个性化的检测需求(可选)
缺陷小图:数据留存,方便缺陷复查(Defect Review)
SICE检测的典型的特征缺陷及倒角测量

裂纹缺陷

崩边缺陷

沾污缺陷

晶圆倒角参数测量
此前,优睿谱已陆续推出国内首发半导体专用FTIR(傅立叶变换红外光谱)测量设备系列(部分型号目前已获得海外客户订单):
适用于硅基外延层膜厚测量设备Eos200/Eos300
适用于硅基元素浓度(B/P/F)测量设备Eos200+/Eos300+
通过优化的硬件设计(更新的红外光谱仪技术)配合自主开发的算法实现对碳化硅外延层膜厚及外延缓冲层膜厚测量设备Eos200L
通过优化的硬件设计(更新的红外光谱仪技术)配合自主开发的Global Fitting Algo. ®算法技术实现碳化硅多层(≥3层)外延膜厚测量设备Eos200L+
硅材料中C/O含量测量设备Eos200T
优睿谱SICV200晶圆电阻率量测设备,实现了完全对标国外供应商测试性能及设备供应链的国产化目标。同时,针对碳化硅外延晶圆CV测量后有金属残留及压痕的行业痛点做了针对性创新开发,成功解决该行业痛点,目前已得到多家客户的订单。
优睿谱针对碳化硅衬底晶圆位错及微管检测设备SICD200,实现了碳化硅位错检测的整片晶圆全检测,该设备已获得境外客户订单。
优睿谱Eos200DSR设备,实现了SOI晶圆重掺顶层硅厚度测量。同时,可用于硅基铌酸锂厚度、晶圆背封LTO厚度及光刻胶厚度测量。
优睿谱成立于2021年,由长期从事于半导体行业的海归博士领衔,协同国内资深的半导体前道制程量测设备技术团队共同发起成立,致力于打造高品质的半导体前道量测设备。